关于焊锡膏常见问题的分析,我们需要先来了解一下焊锡膏的技术,焊锡膏是用在SMT安装技能中的首要板级互连办法,使用的焊锡技术是回流焊。这种焊锡技术把所需要的焊接特性极好地将器件联系在一起,这些特性包含易于加工、对各种SMT规划有广泛的兼容性,具有很高的焊接可靠性以及成本低等;然而,在回流焊接被用作为最首要的SMT元件级和板级互连办法的时候,它也受到请求进一步改善焊接功能的挑战,事实上,回流焊接技能能否经受住这一挑战将决定焊锡膏能否继续作为首要的SMT焊接材料。尤其是在超纤细距离技能不断取得进展的状况之下。下面我们将探讨影响改善回流焊接功能的几个首要常见问题,为发激发工业界研究出处理这一课题的新办法,我们分别对每个问题简要介绍如下:
双面回流焊接已选用多年,在此,先对第一面进行锡膏印刷布线,装置元件和软熔,然后翻过来对电路板的另一面进行加工处理,为了更加节约起见,某些技能省去了对第一面的软熔,而是同时软熔顶面和底面,典型的例子是电路板底面上仅装有小的元件,如芯片电容器和芯片电阻器,因为印刷电路板(PCB)的规划越来越复杂,装在底面上的元件也越来越大,结果软熔时元件掉落成为一个首要的疑问。明显,元件掉落表象是因为软熔时熔化了的焊锡膏对元件的垂直固定力缺乏,而垂直固定力缺乏可归因于元件分量添加,元件的可焊性差,焊剂的潮湿性或焊料量缺乏等。其间,第一个要素是最根本的原因。假如在对后边的三个要素加以改善后仍有元件掉落表象存在,就必须使用SMT粘结剂。明显,使用粘结剂将会使软熔时元件自对准的效果变差。

未焊满是在相邻的引线之间构成焊桥。通常,所有能导致焊锡膏坍落的要素都会致使未焊满,这些要素包含:
1,升温速度太快问题;
2,焊锡膏的触变功能太差或是焊锡膏的粘度在剪切后恢复太慢;
3,金属负荷或固体含量太低的问题;
4,粉料粒度分布太广;
5;助焊剂外表张力太小。
但是,坍落这种常见的情况并非必然导致未焊满,在软熔时,熔化了的未焊满焊料在外表张力的推动下有断开的也许,锡膏流失表象将使未焊满疑问变得更加严重。在此状况下,因为焊料流失而聚集在某一区域的过量的焊锡膏将会使熔融焊料变得过多而不易断开。
除了导致焊锡膏坍落的要素而外,下面的要素也导致未满焊的常见原因:
1,相对于焊点之间的空间而言,焊锡膏熔敷太多的问题;
2,加热温度过高的问题;
3,焊锡膏受热速度比电路板更快;
4,焊剂潮湿速度太快;
5,焊剂蒸气压太低;
6;焊剂的溶剂成分太高的问题;
7,焊剂树脂软化点太低的问题。
焊料膜的断续潮湿是指有水呈现在光滑的外表上,这是因为焊锡膏能粘附在大多数的固体金属外表上,而且在熔化了的焊料掩盖层下隐藏着某些未被潮湿的点,因而,在最初用熔化的焊料来掩盖外表时,会有断续潮湿表象呈现。亚稳态的熔融焊料掩盖层在最小外表能驱动力的效果下会发生缩短,不一会儿之后就聚集成分离的小球和脊状秃起物。断续潮湿也能由部件与熔化的焊料相触摸时放出的气体而导致。因为有机物的热分化或无机物的水合效果而释放的水分都会产生气体。水蒸气是这些有关气体的最多见的成份,在焊接温度下,水蒸气具极强的氧化效果,能够氧化熔融焊料膜的外表或某些外表下的界面(典型的例子是在熔融焊料交界上的金属氧化物外表)。常见的状况是较高的焊接温度和较长的停留时刻会致使更为严重的断续潮湿表象,尤其是在基体金属之中,反应速度的添加会致使更加猛烈的气体释放。与此同时,较长的停留时刻也会延伸气体释放的时刻。以上两方面都会添加释放出的气体量,消除断续潮湿表象问题的办法是:
1,下降焊接温度;
2,缩短软熔的停留时刻;
3,选用流动的慵懒氛围;
4,下降污染程度。
对不用整理的软熔技能而言,为了获得装修上或功能上的效果,常常请求低残留物,对功能请求方面的例子包含“通过在电路中测试的焊锡膏残留物,来探查测试堆焊层以及在刺进接头与堆焊层之间或在刺进接头与软熔焊接点邻近的通孔之间实行电触摸”,较多的锡膏残渣常会致使在要实行电触摸的金属表层上有过多的残留物掩盖的问题,这会妨碍电连接的建立,在电路密度日益添加的状况下,这个常见问题越发受到人们的重视。
明显,不用整理的低残留物焊锡膏是满意这个请求的一个理想的处理办法。然而,与此相关的软熔必要条件却使这个疑问变得更加复杂化了。为了猜测在不同级别的慵懒软熔氛围中低残留物焊锡膏的焊接功能,提出一个半经验的模型,这个模型预示,跟着氧含量的下降,焊接功能会迅速地改善,然后逐渐趋于平稳,实验结果标明,跟着氧浓度的下降,焊接强度和焊锡膏的潮湿能力会有所添加,此外,焊接强度也随锡膏中固体含量的添加而添加。实验数据所提出的模型是可对比的,并强有力地证明了模型是有效的,能够用以猜测焊锡膏与材料的焊接功能,因而,可以断语,为了在焊接技能中成功地选用不用整理的低残留物焊料,应当使用慵懒的软熔氛围。
空隙问题是指在元件引线与电路板焊点之间没有构成焊接点。一般来说,这可归因于以下四方面的原因:
1,锡膏焊料熔敷缺乏;
2,引线共面性差;
3,焊锡膏潮湿不够;
4,焊料损耗枣
这是由预镀锡的印刷电路板上焊锡膏坍落,引线的芯吸效果或焊点邻近的通孔导致的,引线共面性问题是新的分量较轻的12密耳(μm)距离的四芯线扁平集成电路(QFP枣Quad flat packs)的一个特别令人重视的疑问,为了处理这个疑问,提出了在安装之前用焊料来预涂覆焊点的办法,此法是扩大部分焊点的尺度并沿着鼓起的焊料预掩盖区构成一个可控制的部分焊接区,并由此来抵偿引线共面性的变化和防止空隙,引线的芯吸效果可以通过减慢加热速度以及让底面比顶面受热更多来加以处理,此外,使用潮湿速度较慢的锡膏焊剂,较高的活化温度或能延缓熔化的焊膏(如混有锡粉和铅粉的焊锡膏)也能最大极限地减少芯吸效果.在用锡铅掩盖层光整电路板之前,用锡膏掩膜来掩盖连接路径也能防止由邻近的通孔导致的芯吸作(BGA)成球不良。
BGA成球常遇到诸如未焊满,焊球不对准,焊球漏失以及焊锡膏量缺乏等缺点,这通常是因为软熔时对球体的固定力缺乏或自定心力缺乏而导致。固定力缺乏也许是由低粘稠,高阻挡厚度或高放气速度构成的;而自定力缺乏一般由焊剂活性较弱或焊料量过低而导致。
BGA成球效果可通过独自使用焊锡膏或者将焊料球与焊膏以及焊料球与焊剂一起使用来完成; 正确的可行办法是将整体预成形与助焊剂或焊锡膏一起使用。最常见的办法看来是将焊料球与焊膏一起使用,利用锡62或锡63球焊的成球技能产生了极好的效果。在使用焊剂来进行锡62或锡63球焊的状况下,缺点率跟着焊剂粘度,溶剂的挥发性和距离尺度的下降而添加,同时也跟着焊剂的熔敷厚度,焊剂的活性以及焊点直径的添加而添加,在用焊锡膏来进行高温熔化的球焊系统中,没有观察到有焊球漏失表象呈现,而且其对准精确度随焊膏熔敷厚度与溶剂挥发性,焊剂的活性,焊点的尺度与可焊性以及金属负载的添加而添加,在使用锡63焊膏时,焊锡膏的粘度,距离与软熔截面对高熔化温度下的成球率几乎没有影响。在请求选用常规的印刷枣释放技能的状况下,易于释放的焊锡膏对焊锡膏的独自成球是至关首要的。整体预成形的成球技能也是很的发展的出路的。减少焊料链接的厚度与宽度对提高成球的成功率也是相当首要的。
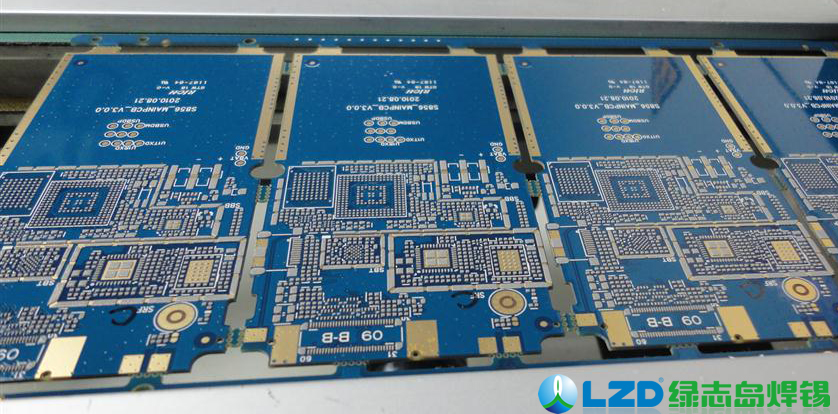
构成孔隙问题通常是一个与焊接接头相关的疑问。尤其是应用SMT技能来软熔焊锡膏的时候,在选用无引线陶瓷芯片的状况下,绝大部分的大孔隙(>0.0005英寸/0.01毫米)是处于LCCC焊点和印刷电路板焊点之间,与此同时,在LCCC城堡状物邻近的角焊缝中,仅有很少数的小孔隙,孔隙的存在会影响焊接接头的机械功能,并会损害接头的强度,延展性和疲劳寿命,这是因为孔隙的生长会聚结成可延伸的裂纹并致使疲劳,孔隙也会使焊料的应力和 协变添加,这也是导致损坏的原因。此外,焊料在凝固时会发生缩短,焊接电镀通孔时的分层排气以及夹带焊剂等也是构成孔隙问题的原因。
在焊接过程中,构成孔隙问题的械制是对比复杂的,一般而言,孔隙问题是由软熔时夹层状结构中的焊料中夹带的焊剂排气而构成的,孔隙的构成首要由金属化区的可焊性决定,并跟着焊剂活性的下降,粉末的金属负荷的添加以及引线接头下的掩盖区的添加而变化,减少焊料颗粒的尺度仅能销许添加孔隙。此外,孔隙的构成也与焊料粉的聚结和消除固定金属氧化物之间的时刻分配有关。焊锡膏聚结越早,构成的孔隙也越多。通常,大孔隙的比例随总孔隙量的添加而添加.与总孔隙量的分析结果所示的状况对比,那些有启发性的导致孔隙构成要素将对焊接接头的可靠性产生更大的影响,控制孔隙构成的办法包含:
1,改善元件/衫底的可焊性;
2,选用具有较高助焊活性的焊剂;
3,减少焊料粉状氧化物;
4,选用慵懒加热氛围.
5,减缓软熔前的预热过程.与上述状况对比,在BGA安装中孔隙的构成遵照一个略有不同的形式.一般说来.在选用锡63焊料块的BGA安装中孔隙首要是在板级安装期间生成的.在预镀锡的印刷电路板上,BGA接头的孔隙量随溶剂的挥发性,金属成分和软熔温度的升高而添加,同时也随粉粒尺度的减少而添加;这可由决定焊剂排出速度的粘度来加以解释.依照这个模型,在软熔温度下,有较高粘度的助焊剂介质会妨碍焊剂从熔融焊料中排出,因而,添加夹带焊剂的数量会增大放气的也许性,从而致使在BGA安装中有较大的孔隙度.在不考虑固定的金属化区的可焊性的状况下,焊剂的活性和软熔氛围对孔隙生成的影响好像可以忽略不计.大孔隙的比例会随总孔隙量的添加而添加,这就标明,与总孔隙量分析结果所示的状况对比,在BGA中导致孔隙生成的要素对焊接接头的可靠性有更大的影响,这一点与在SMT技能中空隙生城的状况相似。
当焊锡膏至于一个加热的环境中,焊锡膏回流分为五个期间:首要,用于达到所需粘度和丝印功能的溶剂开始蒸腾,温度上升必需慢(大概每秒3°C),以约束沸腾和飞溅,防止构成小锡珠,还有,一些元件对内部应力对比敏感,假如元件外部温度上升太快,会构成断裂。
助焊剂活跃,化学清洗举动开始,水溶性助焊剂和免洗型助焊剂都会发生同样的清洗举动,只不过温度稍微不同。将金属氧化物和某些污染从即将联系的金属和焊锡颗粒上清除。好的冶金学上的锡焊点请求“清洗”的外表。
当温度继续上升,焊锡膏颗粒首要独自熔化,并开始液化和外表吸锡的“灯草”过程。这样在所有也许的外表上掩盖,并开始构成锡焊点。
这个期间最为首要,当单个的焊锡颗粒全部熔化后,联系一起构成液态锡,这时外表张力效果开始构成焊脚外表,假如元件引脚与PCB焊盘的空隙超过4mil,则极也许因为外表张力使引脚和焊盘分开,即构成锡点开路。
冷却期间,假如冷却快,锡点强度会稍微大一点,但不可以太快而导致元件内部的温度应力。
回流焊接请求总结:
首要的是有充分的缓慢加热来安全地蒸腾溶剂,防止锡珠构成和约束因为温度膨胀导致的元件内部应力,构成断裂痕可靠性疑问。
其次,助焊剂活跃期间必须有适当的时刻和温度,允许清洗期间在焊锡颗粒刚刚开始熔化时完成。
时刻温度曲线中焊锡熔化的期间是最首要的,必须充分地让焊锡颗粒完全熔化,液化构成冶金焊接,剩余溶剂和助焊剂残余的蒸腾,构成焊脚外表。此期间假如太热或太长,也许对元件和PCB构成伤害。
焊锡膏回流温度曲线的设定,最好是依据焊锡膏供货商提供的数据进行,同时把握元件内部温度应力变化准则,即加热温升速度小于每秒3°C,和冷却温降速度小于5° C。
PCB安装假如尺度和分量很相似的话,可用同一个温度曲线。
首要的是要经常甚至每天检查温度曲线是否正确。
总 结焊锡膏常见问题的分析如下:
焊锡膏的回流焊接是SMT安装技能中的首要的板极互连办法,影响回流焊接的首要问题包含:底面元件的固定、未焊满、断续潮湿、低残留物、空隙、焊料成球、焊料结珠、焊接角焊缝抬起、TombstoningBGA成球不良、构成孔隙等,问题还不仅限于此,在本文中未提及的问题还有浸析效果,金属间化物,不潮湿,歪扭,无铅焊接等.只有处理了这些焊锡膏常见的问题,回流焊接作为一个首要的SMT安装办法,才能在超纤细距离的时代继续成功地保留下去。
相关文章:
焊锡膏在SMT贴片操作中有哪些必须注意的地方
绿志岛焊锡厂免责声明:
绿志岛焊锡厂发布的新闻资料除原创外,有部分是从网络中收集得到的,版权归原作者及原网站所有。绿志岛焊锡厂承诺会尽可能注明信息来源,部分资源因操作上的原因可能丢失了原有信息,敬请原作者谅解,若您对绿志岛焊锡厂所载的文章资讯的版权归有异议,请立即告知绿志岛焊锡厂,绿志岛会尊重您的意见进行删除,同时向您予以致歉。
转载请注明出自东莞绿志岛。